Thiết bị tách laser bán dẫn
Sơ đồ chi tiết


Tổng quan về sản phẩm thiết bị tách lớp bằng laser
Thiết bị tách lớp bán dẫn bằng laser đại diện cho giải pháp thế hệ mới để làm mỏng phôi bán dẫn trong quá trình chế biến vật liệu bán dẫn. Không giống như các phương pháp cắt wafer truyền thống dựa vào mài cơ học, cưa dây kim cương hoặc làm phẳng hóa học-cơ học, nền tảng dựa trên laser này cung cấp một giải pháp thay thế không tiếp xúc, không phá hủy để tách các lớp siêu mỏng khỏi phôi bán dẫn khối.
Được tối ưu hóa cho các vật liệu dễ vỡ và có giá trị cao như gali nitrua (GaN), silic cacbua (SiC), sapphire và gali arsenua (GaAs), thiết bị tách màng bán dẫn bằng laser cho phép cắt chính xác các lớp màng kích thước wafer trực tiếp từ khối tinh thể. Công nghệ đột phá này giúp giảm đáng kể lượng vật liệu thừa, cải thiện năng suất và tăng cường tính toàn vẹn của chất nền — tất cả đều rất quan trọng đối với các thiết bị thế hệ tiếp theo trong lĩnh vực điện tử công suất, hệ thống tần số vô tuyến, quang học và màn hình hiển thị siêu nhỏ.
Với trọng tâm là điều khiển tự động, định hình chùm tia và phân tích tương tác laser-vật liệu, thiết bị tách laser bán dẫn được thiết kế để tích hợp liền mạch vào quy trình chế tạo bán dẫn, đồng thời hỗ trợ tính linh hoạt trong nghiên cứu và phát triển cũng như khả năng mở rộng sản xuất hàng loạt.

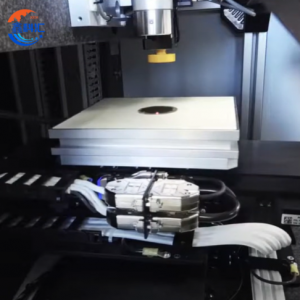
Công nghệ và nguyên lý hoạt động của thiết bị nâng bằng laser
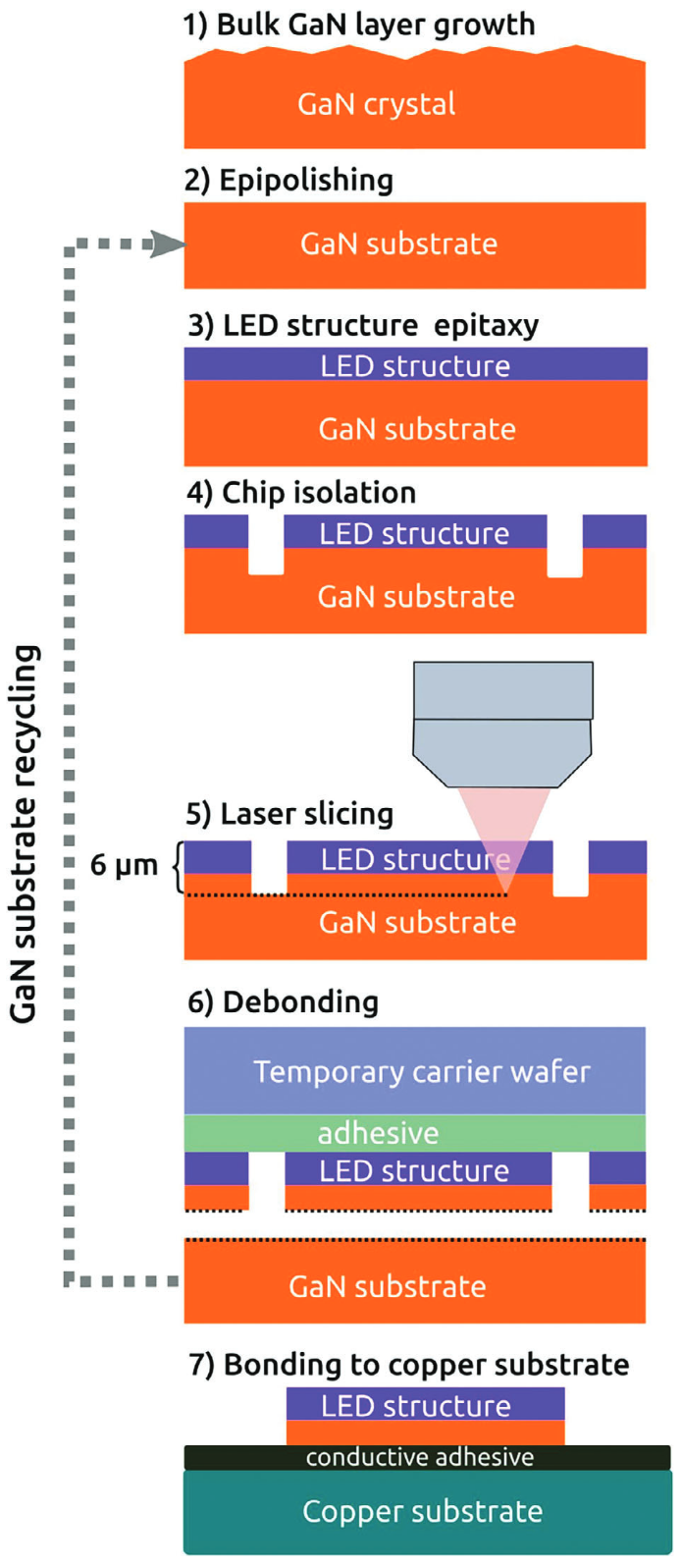
Quy trình được thực hiện bởi thiết bị tách bán dẫn bằng laser bắt đầu bằng việc chiếu xạ thỏi bán dẫn từ một phía bằng chùm tia laser cực tím năng lượng cao. Chùm tia này được hội tụ chặt chẽ vào một độ sâu bên trong cụ thể, thường là dọc theo một giao diện được thiết kế sẵn, nơi sự hấp thụ năng lượng đạt mức tối đa do sự tương phản quang học, nhiệt học hoặc hóa học.
Tại lớp hấp thụ năng lượng này, sự gia nhiệt cục bộ dẫn đến hiện tượng vi nổ nhanh, giãn nở khí hoặc phân hủy lớp giao diện (ví dụ: màng chịu ứng suất hoặc oxit hy sinh). Sự phá vỡ được kiểm soát chính xác này khiến lớp tinh thể phía trên — với độ dày hàng chục micromet — tách ra khỏi khối nền một cách gọn gàng.
Thiết bị tách bán dẫn bằng laser sử dụng đầu quét đồng bộ chuyển động, điều khiển trục Z lập trình được và phép đo phản xạ thời gian thực để đảm bảo mỗi xung laser truyền năng lượng chính xác đến mặt phẳng mục tiêu. Thiết bị cũng có thể được cấu hình với chế độ xung liên tục hoặc đa xung để tăng cường độ mịn của quá trình tách và giảm thiểu ứng suất dư. Quan trọng hơn, vì chùm tia laser không bao giờ tiếp xúc vật lý với vật liệu, nên nguy cơ nứt vi mô, cong vênh hoặc sứt mẻ bề mặt được giảm thiểu đáng kể.
Điều này khiến phương pháp làm mỏng bằng cách tách lớp bằng laser trở thành một bước đột phá, đặc biệt trong các ứng dụng yêu cầu các tấm wafer siêu phẳng, siêu mỏng với độ biến thiên tổng độ dày (TTV) dưới micromet.
Thông số kỹ thuật của thiết bị tách bán dẫn bằng laser.
| Bước sóng | IR/SHG/THG/FHG |
|---|---|
| Độ rộng xung | Nanogiây, Picogiây, Femtogiây |
| Hệ thống quang học | Hệ thống quang học cố định hoặc hệ thống quang-điện |
| Sân khấu XY | 500 mm × 500 mm |
| Phạm vi xử lý | 160 mm |
| Tốc độ di chuyển | Tốc độ tối đa 1.000 mm/giây |
| Khả năng lặp lại | Sai số ±1 μm hoặc nhỏ hơn |
| Độ chính xác vị trí tuyệt đối: | Sai số ±5 μm hoặc nhỏ hơn |
| Kích thước wafer | 2–6 inch hoặc tùy chỉnh |
| Điều khiển | Windows 10, 11 và PLC |
| Điện áp nguồn | Điện áp xoay chiều 200 V ±20 V, một pha, 50/60 kHz |
| Kích thước bên ngoài | 2400 mm (Chiều rộng) × 1700 mm (Chiều sâu) × 2000 mm (Chiều cao) |
| Cân nặng | 1.000 kg |
Ứng dụng công nghiệp của thiết bị tách bằng laser
Thiết bị tách vật liệu bằng laser bán dẫn đang nhanh chóng làm thay đổi cách thức chuẩn bị vật liệu trong nhiều lĩnh vực bán dẫn khác nhau:
- Các thiết bị nguồn GaN thẳng đứng của thiết bị tách laser
Việc tách các lớp màng GaN siêu mỏng trên nền GaN từ các khối GaN lớn cho phép tạo ra các cấu trúc dẫn điện theo chiều dọc và tái sử dụng các chất nền đắt tiền.
- Làm mỏng tấm wafer SiC cho các thiết bị Schottky và MOSFET.
Giảm độ dày lớp thiết bị trong khi vẫn duy trì độ phẳng của chất nền — lý tưởng cho các thiết bị điện tử công suất chuyển mạch nhanh.
- Vật liệu LED và màn hình dựa trên sapphire của thiết bị tách laser
Cho phép tách các lớp thiết bị một cách hiệu quả khỏi các khối sapphire để hỗ trợ sản xuất micro-LED mỏng, tối ưu hóa về mặt nhiệt.
- III-V Kỹ thuật vật liệu của thiết bị tách bằng laser
Hỗ trợ việc tách các lớp GaAs, InP và AlGaN để tích hợp quang điện tử tiên tiến.
- Chế tạo mạch tích hợp và cảm biến trên tấm wafer mỏng
Sản xuất các lớp màng mỏng chức năng cho cảm biến áp suất, gia tốc kế hoặc điốt quang, nơi mà độ dày là một trở ngại về hiệu suất.
- Điện tử linh hoạt và trong suốt
Chuẩn bị các chất nền siêu mỏng phù hợp cho màn hình linh hoạt, mạch đeo được và cửa sổ thông minh trong suốt.
Trong mỗi lĩnh vực này, thiết bị tách bán dẫn bằng laser đóng vai trò quan trọng trong việc cho phép thu nhỏ kích thước, tái sử dụng vật liệu và đơn giản hóa quy trình.

Câu hỏi thường gặp (FAQ) về thiết bị nâng bằng laser
Câu 1: Độ dày tối thiểu tôi có thể đạt được khi sử dụng thiết bị tách bán dẫn bằng laser là bao nhiêu?
A1:Thông thường độ dày nằm trong khoảng 10–30 micron tùy thuộc vào vật liệu. Quy trình này có thể tạo ra kết quả mỏng hơn với các thiết lập được điều chỉnh.
Câu 2: Có thể dùng phương pháp này để cắt nhiều tấm wafer từ cùng một thỏi wafer không?
A2:Đúng vậy. Nhiều khách hàng sử dụng kỹ thuật tách lớp bằng laser để thực hiện việc tách nhiều lớp mỏng liên tiếp từ một thỏi kim loại lớn.
Câu 3: Những tính năng an toàn nào được tích hợp cho hoạt động của laser công suất cao?
A3:Các trang bị tiêu chuẩn bao gồm vỏ bọc cấp 1, hệ thống khóa liên động, tấm chắn chùm tia và hệ thống ngắt tự động.
Câu 4: Hệ thống này so với máy cưa dây kim cương thì như thế nào về mặt chi phí?
A4:Mặc dù chi phí đầu tư ban đầu có thể cao hơn, nhưng công nghệ tách lớp bằng laser giúp giảm đáng kể chi phí vật tư tiêu hao, hư hại chất nền và các bước xử lý sau in — từ đó giảm tổng chi phí sở hữu (TCO) về lâu dài.
Câu 5: Quy trình này có thể mở rộng quy mô cho các thỏi kim loại kích thước 6 inch hoặc 8 inch không?
A5:Chắc chắn rồi. Nền tảng này hỗ trợ các chất nền có kích thước lên đến 12 inch với phân bố chùm tia đồng đều và các bàn chuyển động khổ lớn.
Về chúng tôi
XKH chuyên phát triển, sản xuất và kinh doanh các loại kính quang học đặc biệt và vật liệu tinh thể mới với công nghệ cao. Sản phẩm của chúng tôi phục vụ cho ngành điện tử quang học, điện tử tiêu dùng và quân sự. Chúng tôi cung cấp các linh kiện quang học Sapphire, nắp ống kính điện thoại di động, gốm sứ, LT, Silicon Carbide (SIC), thạch anh và tấm bán dẫn tinh thể. Với chuyên môn cao và thiết bị hiện đại, chúng tôi vượt trội trong gia công các sản phẩm phi tiêu chuẩn, hướng tới mục tiêu trở thành doanh nghiệp công nghệ cao hàng đầu về vật liệu quang điện tử.











